次世代放熱基板開発
より高性能の放熱基板を目指して
IGBTモジュール用 MAGSIC®(マグシック®)Mg-SiC複合材料
当社独自の成形・溶浸技術を用いてMgインゴットとSiC粉末から製造するMAGSICは大型量産品に適しています。標準品では熱膨張7.0ppm、熱伝導230W/(m・K)です。
反り付け形状のばらつきが少なく、ヒートサイクル試験後も反り形状が安定して保持されます。
- 特 徴
-
- ■高い熱伝導率
- ■優れた放熱性と形状安定性
- ■低比重
- ■軽量
- ■塩水に対する優れた耐食性
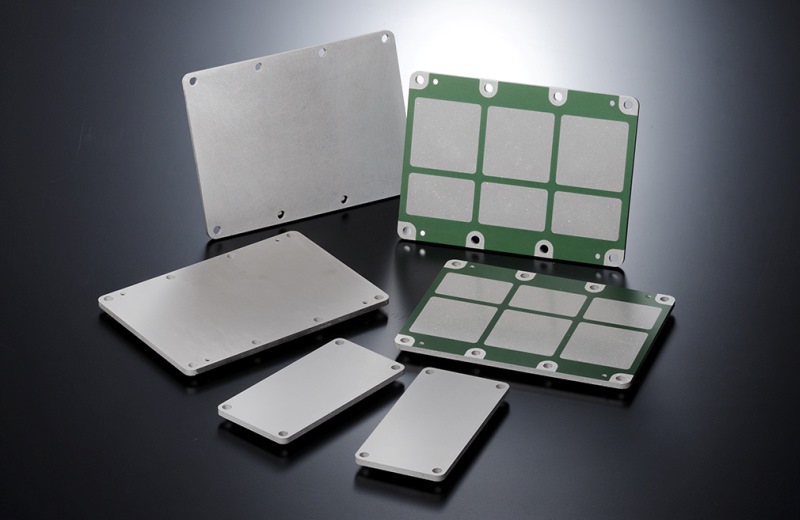

-
IGBTモジュール
(アプリケーション例)
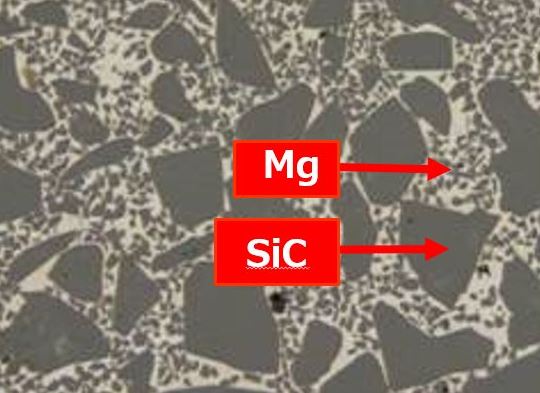
-
MAGSICの組織
高出力デバイス用 Ag-Diamond
- 特 徴
-
- ■600W/(m・K)以上の高熱伝導率
- ■ヒートサイクルによる熱伝導率の低下は極小
- ■表面にNiまたはNi/Auめっき処理が可能
- ■高温ロウ付けに対応

携帯基地局用放熱基板(CPC®)
CPCは、Cu-Moの上下にCu層を備えた積層構造の放熱基板です。 芯材となるCu-Mo材の組成と積層比率の組み合わせで、熱伝導率と線膨張係数を変えられます。
また、両表面がCuであるため、初期の熱放散性効果に優れています。
用途としては、無線通信のうち主に携帯電話基地局のアンプ用基板に使用されています。
CPC®の種類と構造
技術資料ダウンロード
下記リンクから技術資料をダウンロードできます
※ダウンロードには会員登録が必要です
バーレーザーダイオード用
Cu-Diamond / Cu-W サブマウント
Cu-Diamond は、化合物半導体に近い熱膨張係数、かつ銅以上の熱伝導率(>500 W/m・K)を有しています。Cu-W は、銅の高熱伝導特性とタングステンの低熱膨張特性を兼ね備え、周辺材料に合わせて線膨張係数を調整可能です。

ウエハーボンディング用支持基板
(純Mo、Cu-Mo 合金、Cu-W 合金)
Moは半導体素子(Si、GaN、SiC)に近い熱膨張率を有し、半導体素子への熱ストレスを低減することができます。Cu-WとCu-Moは、高熱伝導金属の銅と低熱膨張金属のタングステン、あるいはモリブデンとの複合材料で、周辺材料に合わせて線膨張係数を調整できます。

Ag-Diamond (銀ダイヤモンド)
放熱基板
熱伝導率が金属元素で最高の銀と、地上の物質で最高のダイヤモンド。独自技術で複合化し、600 W/(m・K)以上の熱伝導率を有す放熱基板です。航空・宇宙向けの高出力デバイスに最適です。

CPC放熱基板
(Cu, Cu-Mo, Cu 複合材)
Cu-Moの上下を純銅で挟んだ3層構造の放熱基板です。Cu-Mo材の組成とCuとの積層比率を調整することで、熱伝導率と線膨張係数が可変となります。さらに、表面がCuで初期の熱放散に優れ、量産が可能です。

MAGSIC® (マグシック®)
放熱基板
標準は熱膨張 7.0ppm、熱伝導 230W/(m・K) の軽量、低熱膨張、高熱伝導放熱基板です。MgとSiCの組成比率を変え、熱膨張のカスタマイズも可能です。反り付け形状のばらつきが少なく、ヒートサイクル試験後も反り形状が安定して保持されます。